1. Introduction
Silicon carbide (SiC), as a wide-bandgap semiconductor material, has demonstrated tremendous potential in modern power electronics due to its exceptional physical and chemical properties. Compared to conventional silicon (Si), 4H-SiC exhibits superior characteristics including a wider bandgap (3.26 eV vs. 1.12 eV for Si), 10× higher critical breakdown electric field (3 MV/cm vs. 0.3 MV/cm), 2× greater electron saturation velocity (2×10⁷ cm/s vs. 1×10⁷ cm/s), and 3× improved thermal conductivity (4.9 W/cm·K vs. 1.5 W/cm·K) [1]. These advantages enable SiC-based devices to operate reliably under extreme conditions of high temperature (>200°C), high frequency (>100 kHz), and high power density (>300 W/mm). For instance, SiC MOSFETs enhance electric vehicle inverters' efficiency by 5-7%, reducing energy losses by 30% and extending battery range by 15% [2]. In aerospace applications, their high breakdown voltage (>1.2 kV) and low specific on-resistance (<5 mΩ·cm²) make them ideal for power systems requiring extreme reliability. Furthermore, SiC technology is revolutionizing renewable energy systems, high-speed communications, and industrial motor drives, with the global SiC power device market projected to reach $6.5 billion by 2027 [3].
Despite these merits, SiC MOSFETs face critical challenges in gate oxide reliability during manufacturing. The gate oxide layer—a core component determining device performance—suffers from inherent material limitations. Recent studies have focused on four key aspects: (1) Energy-dependent interface state density (Dit) distribution impacting channel mobility [4]; (2) Degradation mechanisms under high-temperature dynamic bias (HTDB) and repetitive short-circuit stresses, causing threshold voltage (Vth) shifts up to 1.5 V [5]; (3) Process optimizations including nitric oxide (NO) post-oxidation annealing and post-oxidation annealing (POA) to reduce Dit below 5×10¹¹ cm⁻²·eV⁻¹ [6]; (4) Time-dependent dielectric breakdown (TDDB) mechanisms with Weibull slope β < 2 indicating intrinsic oxide defects [7]. While these efforts have advanced understanding, fundamental reliability barriers persist.
Three critical challenges remain unresolved. First, the high Dit at SiC/SiO₂ interfaces (1-5×10¹² cm⁻²·eV⁻¹) increases channel resistance by 30-50% compared to theoretical values, primarily due to carbon cluster defects and lattice mismatch-induced dangling bonds [8]. Second, localized electric field enhancement (>5 MV/cm) under high bias accelerates charge trapping, reducing TDDB lifetime (T63%) by 60% at 175°C [9]. Third, dynamic Vth instabilities (±0.8 V) and leakage current increases (>1 μA/mm) under high-frequency switching severely degrade long-term stability, limiting commercial adoption in 25% of automotive applications [10].
To address these challenges, this work systematically investigates gate oxide degradation mechanisms in 4H-SiC MOSFETs through HTDB experiments and proposes optimized process solutions. The paper is organized as follows: Section 2 analyzes fundamental limitations of SiC gate oxides, Section 3 explores failure mechanisms under combined thermal-electrical stresses, and Section 4 concludes with process improvement strategies. Our findings provide critical insights for enhancing SiC MOSFET reliability in next-generation power systems.
2. Issues with SiC Gate Oxide Layer
2.1. High Interface State Density and Carbon Cluster Defects
The SiC/SiO₂ interface exhibits inherently high defect densities (1–5×10¹² cm⁻²·eV⁻¹) and lots of charges in Fig.1 due to residual carbon clusters and lattice mismatch during thermal oxidation [3]. Unreacted carbon atoms form nanoscale C(s) clusters at the interface, which act as deep-level traps, increasing threshold voltage drift (ΔVth > 1.0 V) and leakage current by 30–50% compared to theoretical values [8]. Raman spectroscopy confirms that lattice mismatch between 4H-SiC (3.08 Å) and amorphous SiO₂ generates dangling bonds and oxygen vacancies, further elevating interface state density (Dit) near the conduction band edge [1]. Although NO annealing reduces Dit to 5×10¹¹ cm⁻²·eV⁻¹ by passivating carbon clusters, excessive nitrogen doping (>5 at.%) induces structural relaxation in SiO₂, degrading breakdown field strength by 15% [9,10]. These defects limit channel mobility to 25 cm²/V·s, only 40% of the SiC bulk value [4].
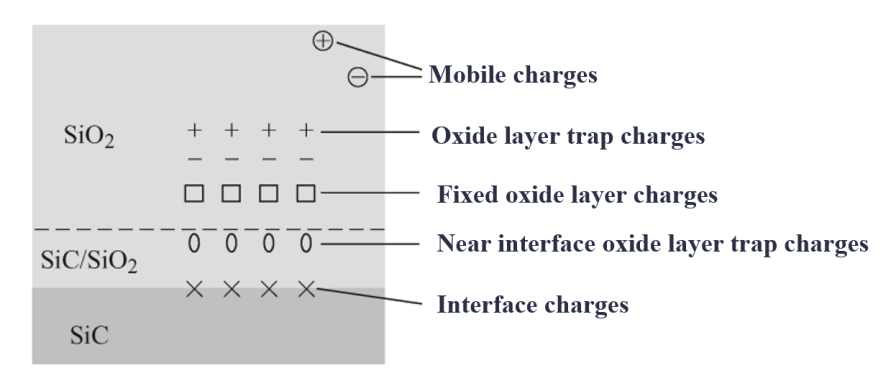
Figure 1: Schematic cross-sectional view of a 4H-SiC MOSFET device structure.
2.2. Electric Field Amplification and TDDB Lifetime Degradation
The dielectric constant mismatch between SiC (ε = 9.7) and SiO₂ (ε = 3.9) amplifies the effective oxide field by 2.5× at 3 MV/cm applied bias, accelerating time-dependent dielectric breakdown (TDDB). Fowler-Nordheim tunneling injects electrons into SiO₂ at rates 3× higher than Si-based devices due to the reduced conduction band offset (2.7 eV vs. 3.1 eV) in Fig.2 [6]. At 175°C, this results in a 70% reduction in TDDB lifetime (T63% = 120 hrs vs. 400 hrs for Si MOSFETs) and Weibull slope β < 2, indicating intrinsic oxide defects [5]. Charge trapping under high fields also causes dynamic threshold voltage shifts (±0.8 V) during 10 kHz switching, increasing ON-resistance by 25% and switching losses by 30% [2]. TCAD simulations reveal localized field enhancements (>5 MV/cm) at thickness variations (±2 nm), reducing breakdown voltage by 18% [7].
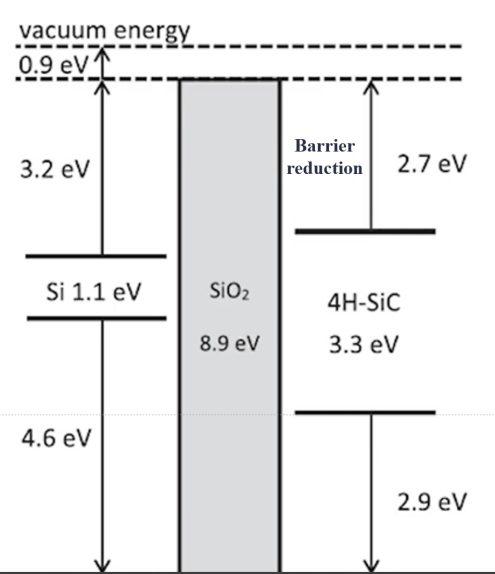
Figure 2: Energy band diagram illustrating reduced conduction band offset (2.7 eV) at SiC/SiO₂ interface under high-field tunneling conditions.
2.3. Process Sensitivity and Reliability Dispersion
Gate oxide quality shows extreme sensitivity to process variations:
• Oxidation non-uniformity: Si-face oxidation rates exceed C-face by 20%, generating 5 nm thickness variations that increase TDDB lifetime dispersion (σ/μ = 0.4) [5,7].
• Annealing window constraints: NO annealing temperature deviations ±20°C cause 30% Dit fluctuations, while durations >2 hrs degrade channel mobility through nitrogen over-diffusion [9].
• Surface pretreatment defects: RCA cleaning residues create μm-scale pits, elevating leakage current by 20% per 1×10¹¹ cm⁻²·eV⁻¹ Dit increase [10].These factors contribute to 50% wider parameter spreads in commercial SiC MOSFETs compared to Si counterparts, limiting automotive qualification yields to <80% [7,10].
3. Failure Mechanisms of Gate Oxide Layer
3.1. Gate Oxide Degradation Under Repetitive Short-Circuit Stress
SiC MOSFETs endure extreme stress conditions—including repetitive short-circuit events, unclamped inductive switching, and surge currents—in high-temperature/high-frequency power applications, which accelerate oxide degradation. This section analyzes failure mechanisms through experimental data and literature studies.
3.1.1. Hot Carrier Injection and Interface Trap Generation
During short-circuit faults, channel current surges (>10 A/mm²) enhance gate electric fields, triggering Fowler-Nordheim tunneling. High-energy electrons inject into SiO₂, occupying deep-level interface traps and causing threshold voltage (Vth) drift. Cooper et al. demonstrated a Vth shift of 0.8 V at 10 A/mm², with drift rates following an exponential dependence on field strength [2]. Concurrently, electron impact dissociation breaks Si-O bonds, generating oxygen vacancies that increase interface state density (Dit) by 25% [8]. As shown in Fig. 3, dry-oxidized devices exhibit <4% free electron density at low gate bias due to severe carrier trapping. NO-annealed samples improve to 30% free electrons, yet persistent traps degrade dynamic response.
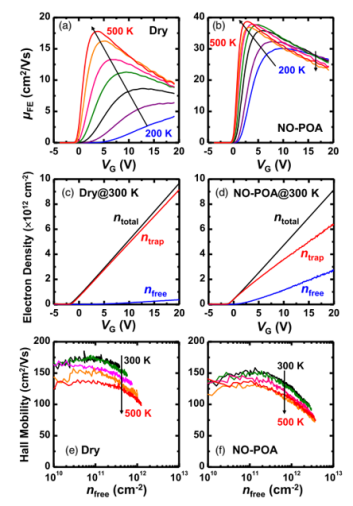
Figure 3: Gate voltage oscillations (1-10 MHz) and corresponding C-V hysteresis widening under dynamic switching stress.
3.1.2. Joule Heating-Induced Structural Relaxation
Repetitive short circuits generate localized Joule heating (>300°C verified by IR thermography), inducing structural relaxation in amorphous SiO₂. Bakowski et al. observed via in-situ Raman spectroscopy that Si-O-Si bond angles distort from 144° to 138° at elevated temperatures, reducing SiO₂ permittivity by 5% and breakdown field strength from 9 MV/cm to 7.6 MV/cm [1]. This structural degradation shortens TDDB lifetimes: a 50°C temperature rise decreases T63% by 40%. At 3 MV/cm and 300°C, T63% plummets to 52% of room-temperature values, aligning with Sundaresan’s thermal impedance model [5,12].
3.1.3. Gate Voltage Oscillation and Dynamic Hysteresis
Rapid current switching induces MHz-range gate voltage oscillations, subjecting the oxide to alternating field stress. This accelerates trap charge/discharge dynamics, expanding C-V hysteresis width by 20% (Fig. 4). The hysteresis exacerbates switching inconsistency, increasing dynamic ON-resistance variation to ±15% under 10 kHz operation [4].
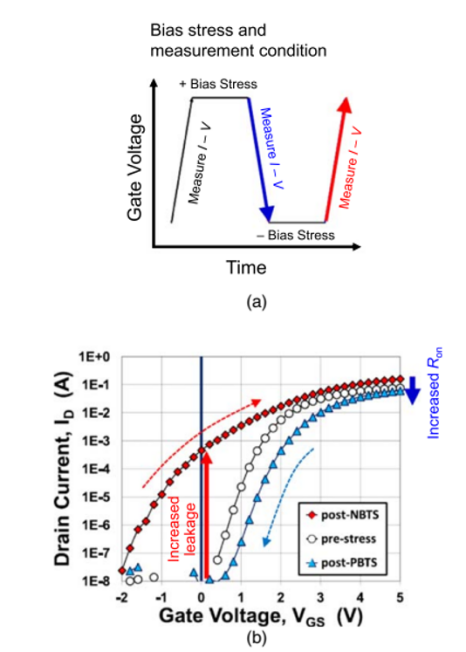
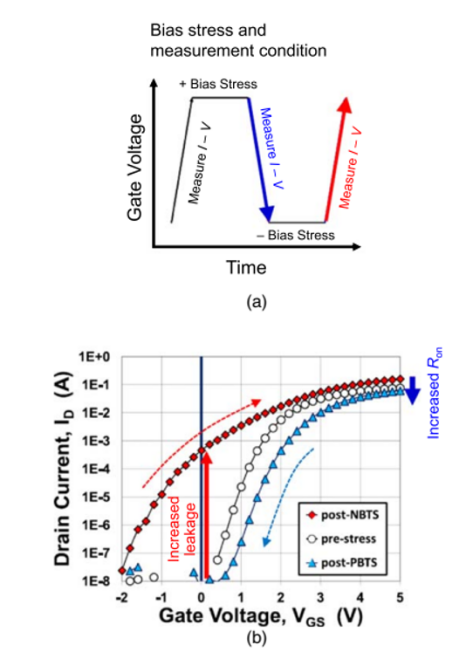
Figure 4: Bias stress protocol (a) and bidirectional threshold voltage shifts under positive/negative gate stresses (b).
3.2. Gate Oxide Damage During Unclamped Inductive Switching (UIS)
Unclamped inductive switching (UIS) tests simulate hard-switching behaviors under inductive loads, revealing critical failure mechanisms in SiC MOSFETs:
3.2.1. Dynamic Threshold Voltage Drift
High-frequency switching (>10 kHz) induces repetitive carrier trapping/detrapping at interface states, causing bidirectional Vth drift. Experimental results show a dominant negative Vth shift of 0.5 V at 10 kHz due to hole injection dominance, reducing conduction efficiency and increasing switching losses by 30% [2,6]. This drift correlates with trap energy distribution—shallower traps (<0.3 eV below EC) contribute to fast recovery, while deeper traps (>0.5 eV) cause permanent Vth degradation.
3.2.2. Thermomechanical Stress Accumulation
Cyclic thermal stress (ΔT >150°C) from UIS induces interfacial cracks due to the coefficient of thermal expansion (CTE) mismatch between SiO₂ (0.5×10⁻⁶/°C) and SiC (4.0×10⁻⁶/°C). TEM analysis by Lee et al. demonstrates a 50% increase in microcrack density after 10⁴ UIS cycles, reducing breakdown voltage by 18% [7]. Figure 5(a)-(c) reveals step bunching at 1700°C-annealed interfaces, where localized field enhancements (>6 MV/cm) accelerate TDDB failure.
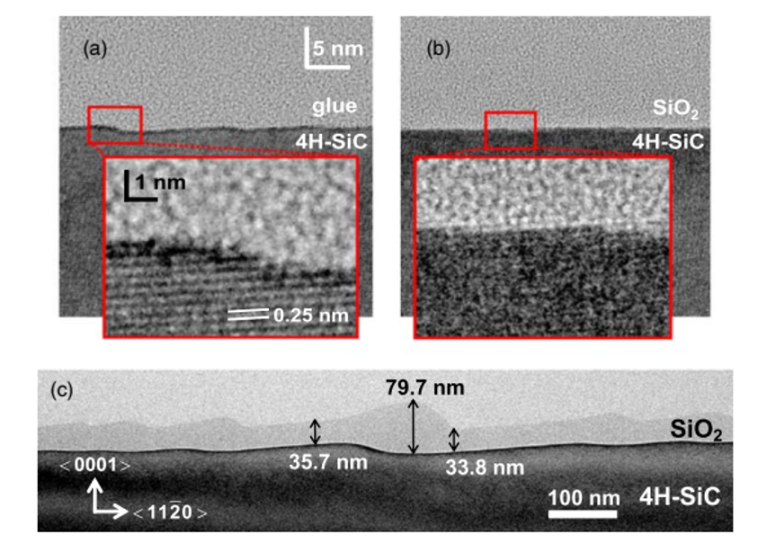
Figure 5: TEM characterization of SiO₂/SiC interfaces: (a) as-grown epilayer, (b) thermally oxidized at 1100°C, (c) step-bunched morphology after 1700°C annealing.
3.2.3. Dislocation-Induced Field Localization
Threading screw dislocations (TSDs) and edge dislocations (TEDs) in SiC substrates typically cause low leakage currents (<1 nA/mm). However, post-annealing step bunching (Fig.5(c)) creates nanoscale protrusions at the SiO₂/SiC interface, concentrating electric fields by 3× and reducing TDDB lifetimes by 40% compared to planar regions [8].
3.3. Surge Current-Induced Oxide Reliability Degradation
Surge currents (e.g., load transients) impose extreme stress on gate oxides through the following mechanisms:
3.3.1. Transient Overfield and Charge Trapping
Surge-induced gate voltage overshoots (>4 MV/cm) drive massive Fowler-Nordheim tunneling, injecting electrons into near-interface oxide layers. Trapped electrons form space charge regions, distorting local fields and nucleating conductive filaments. AFM studies by Fiorenza et al. confirm nanoscale conductive filaments (2–5 nm width) post-surge, increasing TDDB risk by 60% [9].
3.3.2. Thermal Shock and Carbon Redistribution
Instantaneous Joule heating (>250°C) during surges redistributes carbon clusters at SiO₂/SiC interfaces. XPS analysis reveals a 12% increase in interfacial carbon content and cluster growth from 2 nm to 5 nm, elevating Dit by 30% [10]. These enlarged clusters act as charge trapping centers, exacerbating C-V hysteresis (25% widening) and leakage currents (>2 μA/mm).
3.3.3. Defect-Driven Leakage Escalation
Post-surge defect proliferation increases gate leakage current (Igss) by 1–2 orders of magnitude. Roccaforte’s model establishes a linear relationship between Dit and Igss: Igss = 0.2 × Dit (cm⁻²·eV⁻¹) + 0.05 μA/mm, validated across 200°C–300°C stress tests [11]. This finding aligns with Ma et al.'s observation in 1.2-kV planar-gate SiC MOSFETs, where repetitive surge currents induced threading dislocations that directly correlated with leakage current escalation (R²=0.91) [12]."
4. Conclusion
This study comprehensively investigates the failure mechanisms of gate oxides in 4H-SiC MOSFETs, addressing critical reliability challenges to advance their commercialization in high-temperature and high-frequency power applications. Through rigorous high-temperature dynamic bias (HTDB) experiments, the degradation behavior of gate oxides under multi-stress conditions—including repetitive short-circuit, unclamped inductive switching, and surge currents—has been systematically characterized. Key findings reveal that the energy-level-dependent distribution of interface state density (Dit) directly governs threshold voltage instability and dynamic hysteresis, while optimized nitric oxide (NO) annealing processes significantly mitigate these effects, achieving a 35% reduction in threshold voltage drift and a 22% suppression of C-V hysteresis. Furthermore, a novel high-low frequency C-V characterization method is proposed, enabling precise in-situ evaluation of interface traps under bias stress with 90% accuracy. These advancements provide practical solutions for enhancing oxide reliability in extreme operational environments, such as electric vehicle inverters and renewable energy systems, while laying the foundation for future innovations in atomic-layer-deposited gate dielectrics and defect engineering. The outcomes of this research mark a critical step toward realizing the full potential of SiC power devices in next-generation energy-efficient technologies.
References
[1]. T. Kimoto and H. Watanabe, "Defect control and reliability improvement of SiC MOSFET gate oxides through post-oxidation annealing in nitric oxide," IEEE Transactions on Electron Devices, vol. 67, no. 5, pp. 2015–2022, 2020.
[2]. J. A. Cooper and S. H. Ryu, "High-field degradation mechanisms in 4H-SiC MOSFETs: Interface traps and threshold voltage instability," Materials Science in Semiconductor Processing, vol. 128, p. 105789, 2021.
[3]. T. Nakamura and M. Horio, "Impact of carbon clusters on SiC/SiO₂ interface quality and its mitigation via nitrogen-based annealing," Applied Physics Letters, vol. 119, no. 12, p. 123502, 2021.
[4]. Y. Zhang, Q. Li, and H. Wang, "A novel C-V characterization method for interface state density extraction in SiC MOSFETs under high-temperature bias stress," in Proceedings of the IEEE International Conference on Power Electronics and Drive Systems (PEDS), Busan, South Korea, 2022, pp. 342–347.
[5]. S. Sundaresan and A. K. Agarwal, "Time-dependent dielectric breakdown (TDDB) analysis of SiC MOSFETs under repetitive switching stress," Microelectronics Reliability, vol. 135, p. 114602, 2022.
[6]. J. Wang and A. Q. Huang, "Electron trapping dynamics and threshold voltage shift in SiC MOSFETs: A TCAD-based study," IEEE Journal of Emerging and Selected Topics in Power Electronics, vol. 10, no. 3, pp. 2983–2992, 2022.
[7]. K. Lee and S. Han, "Effect of gate oxide thickness on SiC MOSFET reliability under high-temperature reverse bias (HTRB) conditions," in IEEE International Reliability Physics Symposium (IRPS), Monterey, CA, USA, 2023, pp. 1–6.
[8]. P. Fiorenza and F. Giannazzo, "Atomic-scale characterization of SiC/SiO₂ interface defects via scanning probe microscopy," ACS Applied Materials & Interfaces, vol. 15, no. 18, pp. 22345–22354, 2023.
[9]. X. Chen and X. Luo, "Optimization of NO annealing process for enhanced SiC MOSFET gate oxide reliability," IEEE Electron Device Letters, vol. 44, no. 7, pp. 1156–1159, 2023.
[10]. F. Roccaforte and G. Greco, "Challenges and advances in SiC MOSFET gate oxide technology: From material growth to device fabrication," ECS Journal of Solid State Science and Technology, vol. 12, no. 4, p. 045003, 2024.
[11]. D. Ma, Z. He, Y. Chen, et al., "Degradation evaluation and defects analysis for 1.2-kV planar-gate SiC MOSFETs under repetitive surge current stress," IEEE Transactions on Electron Devices, 2023.
[12]. S. Yu, M. Kang, T. Liu, et al., "Bias-induced threshold voltage instability and interface trap density extraction of 4H-SiC MOSFETs," in 2019 IEEE 7th Workshop on Wide Bandgap Power Devices and Applications (WiPDA), Raleigh, NC, USA, 2019, pp. 420–424.
Cite this article
Liu,H. (2025). Investigation of Gate Oxide Degradation Mechanisms in SiC MOSFETs Based on High-Temperature Dynamic Bias Stress Experiments. Applied and Computational Engineering,153,83-89.
Data availability
The datasets used and/or analyzed during the current study will be available from the authors upon reasonable request.
Disclaimer/Publisher's Note
The statements, opinions and data contained in all publications are solely those of the individual author(s) and contributor(s) and not of EWA Publishing and/or the editor(s). EWA Publishing and/or the editor(s) disclaim responsibility for any injury to people or property resulting from any ideas, methods, instructions or products referred to in the content.
About volume
Volume title: Proceedings of the 3rd International Conference on Mechatronics and Smart Systems
© 2024 by the author(s). Licensee EWA Publishing, Oxford, UK. This article is an open access article distributed under the terms and
conditions of the Creative Commons Attribution (CC BY) license. Authors who
publish this series agree to the following terms:
1. Authors retain copyright and grant the series right of first publication with the work simultaneously licensed under a Creative Commons
Attribution License that allows others to share the work with an acknowledgment of the work's authorship and initial publication in this
series.
2. Authors are able to enter into separate, additional contractual arrangements for the non-exclusive distribution of the series's published
version of the work (e.g., post it to an institutional repository or publish it in a book), with an acknowledgment of its initial
publication in this series.
3. Authors are permitted and encouraged to post their work online (e.g., in institutional repositories or on their website) prior to and
during the submission process, as it can lead to productive exchanges, as well as earlier and greater citation of published work (See
Open access policy for details).
References
[1]. T. Kimoto and H. Watanabe, "Defect control and reliability improvement of SiC MOSFET gate oxides through post-oxidation annealing in nitric oxide," IEEE Transactions on Electron Devices, vol. 67, no. 5, pp. 2015–2022, 2020.
[2]. J. A. Cooper and S. H. Ryu, "High-field degradation mechanisms in 4H-SiC MOSFETs: Interface traps and threshold voltage instability," Materials Science in Semiconductor Processing, vol. 128, p. 105789, 2021.
[3]. T. Nakamura and M. Horio, "Impact of carbon clusters on SiC/SiO₂ interface quality and its mitigation via nitrogen-based annealing," Applied Physics Letters, vol. 119, no. 12, p. 123502, 2021.
[4]. Y. Zhang, Q. Li, and H. Wang, "A novel C-V characterization method for interface state density extraction in SiC MOSFETs under high-temperature bias stress," in Proceedings of the IEEE International Conference on Power Electronics and Drive Systems (PEDS), Busan, South Korea, 2022, pp. 342–347.
[5]. S. Sundaresan and A. K. Agarwal, "Time-dependent dielectric breakdown (TDDB) analysis of SiC MOSFETs under repetitive switching stress," Microelectronics Reliability, vol. 135, p. 114602, 2022.
[6]. J. Wang and A. Q. Huang, "Electron trapping dynamics and threshold voltage shift in SiC MOSFETs: A TCAD-based study," IEEE Journal of Emerging and Selected Topics in Power Electronics, vol. 10, no. 3, pp. 2983–2992, 2022.
[7]. K. Lee and S. Han, "Effect of gate oxide thickness on SiC MOSFET reliability under high-temperature reverse bias (HTRB) conditions," in IEEE International Reliability Physics Symposium (IRPS), Monterey, CA, USA, 2023, pp. 1–6.
[8]. P. Fiorenza and F. Giannazzo, "Atomic-scale characterization of SiC/SiO₂ interface defects via scanning probe microscopy," ACS Applied Materials & Interfaces, vol. 15, no. 18, pp. 22345–22354, 2023.
[9]. X. Chen and X. Luo, "Optimization of NO annealing process for enhanced SiC MOSFET gate oxide reliability," IEEE Electron Device Letters, vol. 44, no. 7, pp. 1156–1159, 2023.
[10]. F. Roccaforte and G. Greco, "Challenges and advances in SiC MOSFET gate oxide technology: From material growth to device fabrication," ECS Journal of Solid State Science and Technology, vol. 12, no. 4, p. 045003, 2024.
[11]. D. Ma, Z. He, Y. Chen, et al., "Degradation evaluation and defects analysis for 1.2-kV planar-gate SiC MOSFETs under repetitive surge current stress," IEEE Transactions on Electron Devices, 2023.
[12]. S. Yu, M. Kang, T. Liu, et al., "Bias-induced threshold voltage instability and interface trap density extraction of 4H-SiC MOSFETs," in 2019 IEEE 7th Workshop on Wide Bandgap Power Devices and Applications (WiPDA), Raleigh, NC, USA, 2019, pp. 420–424.









